- 首页
- 公司简介
- 最新消息
- 产品展示
- 应用案例
- 售后维修
- 档案下载
- 诚招代理
伯东企业(上海)有限公司
Hakuto Enterprises(Shanghai) Ltd.
各式配置
其他
射频离子源 RFICP 380 基本尺寸

BOE-THERM 油式模温机 TEMP 150 温度曲线

BOE-THERM 油式模温机 TEMP 150 温度曲线
BOE-THERM 油式模温机 TEMP 300 温度曲线

BOE-THERM 油式模温机 TEMP 300 温度曲线
BOE-THERM 油式模温机 TEMP 350 温度曲线图

BOE-THERM 油式模温机 TEMP 350 温度曲线图
BOE-THERM 水式模温机 90XS 温度曲线

BOE-THERM 水式模温机 TEMP 95 S 温度曲线

BOE-THERM 水式模温机 TEMP 95 M 温度曲线图

BOE-THERM 水式模温机 TEMP 120 S 温度曲线

BOE-THERM 水式模温机 TEMP 120 M

BOE-THERM 水式模温机 TEMP 140 S

BOE-THERM 水式模温机 TEMP 160 S 温度曲线曲

涡轮分子泵 HiPace 80 Neo 抽气性能
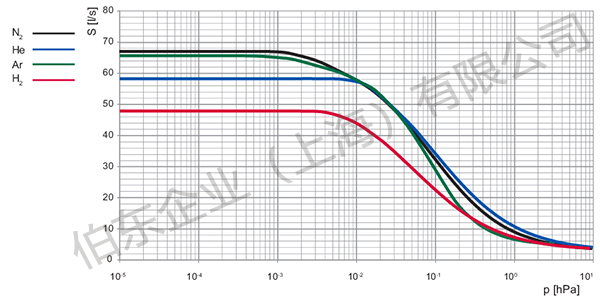
HiPace 30 Neo 抽速图

抽速

Polycold EverCool 30 抽水汽能力
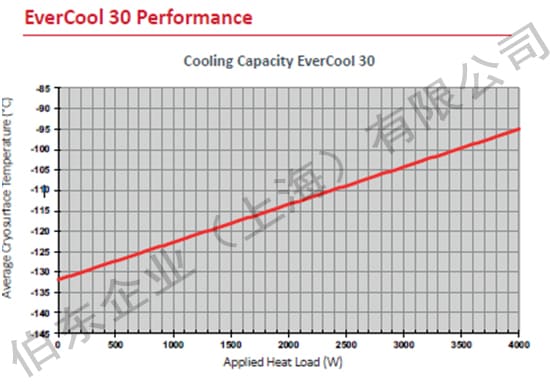
Polycold MaxCool 4000 H 水汽深冷泵 抽水汽效率

Polycold MaxCool 2500 L 水汽深冷泵 抽水汽效率
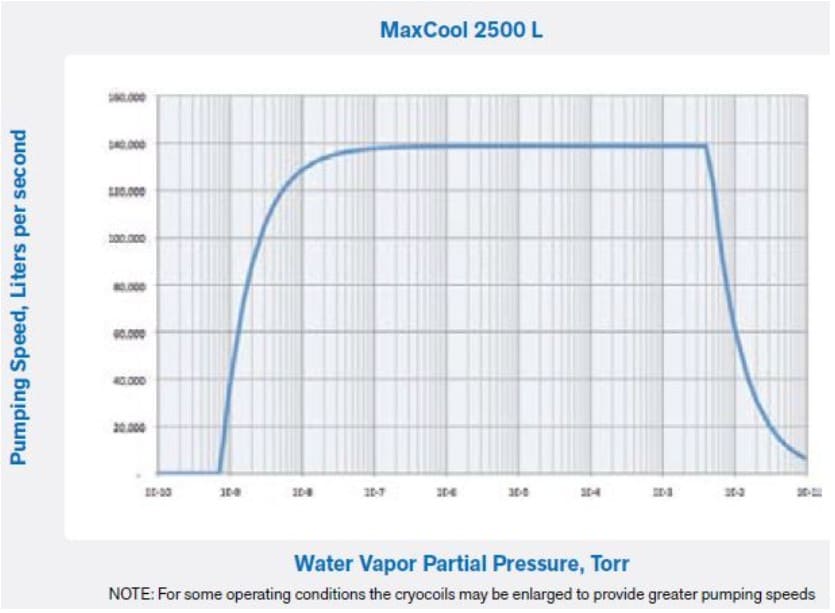
Polycold MaxCool 2000 水汽深冷泵 抽水汽效率:
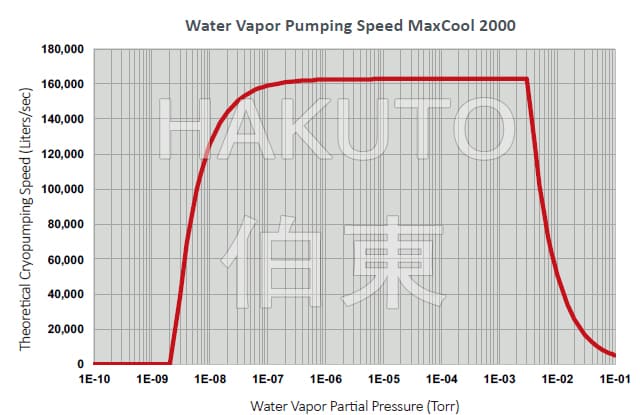
KRI 射频离子源 RFICP 220 基本尺寸

氦质谱检漏仪 ASM 340 尺寸图

氦质谱检漏仪 ASM 340 尺寸图
Pfeiffer 普发防爆型双级旋片泵 DUO 11 ATEX 抽速

Pfeiffer 普发防爆型双级旋片泵 DUO 11 ATEX 抽速
Pfeiffer 普发防爆型双级旋片泵 DUO 11 ATEX 尺寸

Pfeiffer 普发防爆型双级旋片泵 DUO 11 ATEX 尺寸
Pfeiffer 普发干式涡旋泵 HiScroll 46 抽速

Pfeiffer 普发干式涡旋泵 HiScroll 46 尺寸图

真空角阀 AVC 025 SA 尺寸图

PKR 251 尺寸图

应用案例
上海伯东针对不同客户, 提供定制化解决方案并能与客户携手合作研发新的项目应用
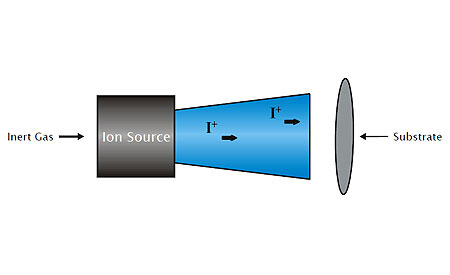
美國 KRi 射頻離子源 RFICP 220 MEMS 探針光柵刻蝕應用
高能量 22cm 柵極離子源, MEMS 探針光柵刻蝕, 材料為 Sio2 和金屬, 刻蝕均勻性 ±5%
伯東 GEL-PAK AD / APV / AV 真空吸附盒對比
伯東 GEL-PAK AD / APV / AV 真空吸附盒對比

美國 KRi 射頻離子源 RFICP 220 MEMS 晶圓蝕刻
刻蚀 6寸或8寸 MEMS 晶圆, 材料为 Au / Ti ; 铁磁性多层膜蚀刻, 材料为 RU, Co, Fe, Pt, Ta.

KRi 射頻離子源 RFICP 380 樹脂鏡片高性能 AR 工藝
手機鏡頭等上游供應商在生產工藝中通常使用離子源進行輔助沉積, 由此改善由手機攝像頭內樹脂鏡片非有效徑區域透光跟反射光線形成的 flare 現象
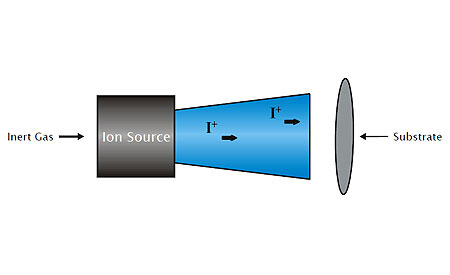
美國 KRi 射頻離子源 RFICP 220 MEMS 探針光柵刻蝕應用
高能量 22cm 柵極離子源, MEMS 探針光柵刻蝕, 材料為 Sio2 和金屬, 刻蝕均勻性 ±5%

上海伯东 Pfeiffer 普发分流式分子泵 SplitFlow 80 应用于氦质谱检漏仪
SplitFlow 80 分流式分子泵独立机械和真空结构设计, 集成在氦质谱检漏仪真空系统中

上海伯东 Pfeiffer 普发分流式分子泵 SplitFlow 80 应用于氦质谱检漏仪
SplitFlow 80 分流式分子泵独立机械和真空结构设计, 集成在氦质谱检漏仪真空系统中
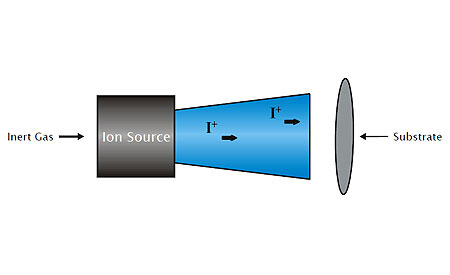
美國 KRi 射頻離子源 RFICP 220 MEMS 探針光柵刻蝕應用
高能量 22cm 柵極離子源, MEMS 探針光柵刻蝕, 材料為 Sio2 和金屬, 刻蝕均勻性 ±5%

Pfeiffer 普发氦质谱检漏仪 ASM 340 光学镀膜机检漏
ASM 340 光学镀膜机检漏, 真空模式下, 漏率要求达到 1X10-7 mbar l/s, 保证光学镀膜机在生产过程中的密封性.

美國 KRi 射頻離子源 RFICP 220 增強光學基片反射及透射率
RFICP 220 通過玻璃鏡片表面清潔 Pre-clean 和輔助鍍膜 IBAD 工藝, 增強光學基片反射及透射率

ph-instruments SRG 磁懸浮轉子真空計可替代 MKS, INFICON 離子規
可以替代離子規 MKS 903 AP,MKS GP 390,MKS GP 355,MKS GP 354, Inficon HPG400,Inficon MPG400 等型號
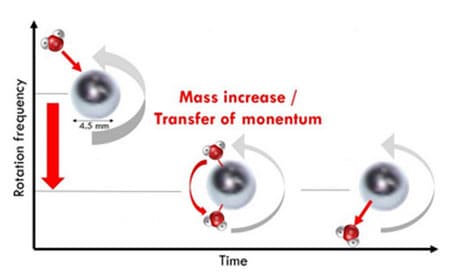
SRG 旋轉轉子真空計測量原理
SRG 旋轉轉子真空計測量原理,穩定測量優勢,固有的抗污染性和堅固設計,高精度和長期穩定性

KRi 直流磁控濺射電源應用於金屬靶材濺射
KRi 直流磁控濺射電源應用於金屬靶材濺射

ph-instruments Dositorr SRG 磁懸浮轉子真空計離子注入應用
SRG 磁懸浮轉子真空計, 耐腐蝕, 無污染, 對沉積不敏感. 可替代離子注入工藝中的離子規, 解決常規離子規經常失效, 信號漂移等問題.

SRG 旋轉轉子真空規與離子規對比
SRG 旋轉轉子真空計精度高, 長期穩定, 不影響以任何方式測量的壓力信號(無溫度輸入 / 電離 / 採集 / 漂移等), 適用於半導體, 低溫真空絕熱, 高精度真空計校準系統.

SRG 磁懸浮轉子規原理和特點(耐腐蝕,高精度,長期穩定)
SRG 旋轉轉子是一種高精度且穩定的真空測量技術, 核心感測元件是一個小型磁懸浮的鋼球, 透過管件連接到真空系統內

SRG 磁懸浮轉子真空計應用於顯示面板腔體測量
磁懸浮轉子真空計具有長期的堅固性, 高度準確和穩定的壓力讀數, 耐腐蝕和沉積, 即使在腐蝕工藝中, 其他儀錶可能會漂移和失效, SRG 磁懸浮轉子真空計無影響.

SRG 磁懸浮轉子真空計應用優勢
耐腐蝕和沉積, 無燈絲設計, 替代傳統的離子規(冷陰極離子規或熱陰極離子規)

KRi 射頻離子源 RFICP 40 應用於氧化物薄膜及異質結製備系統
KRi 射頻離子源 RFICP 40 協助完成 MgO, Y2O3, Al2O3 等金屬氧化物在 6寸單晶矽上均勻沉積多層膜的需要, 單晶矽鍍氧化薄膜的工藝過程

美國 KRi 射頻離子源 RFICP 220 增強光學基片反射及透射率
RFICP 220 通過玻璃鏡片表面清潔 Pre-clean 和輔助鍍膜 IBAD 工藝, 增強光學基片反射及透射率

美國 KRi 射頻離子源 RFICP 220 MEMS 晶圓蝕刻
刻蚀 6寸或8寸 MEMS 晶圆, 材料为 Au / Ti ; 铁磁性多层膜蚀刻, 材料为 RU, Co, Fe, Pt, Ta.
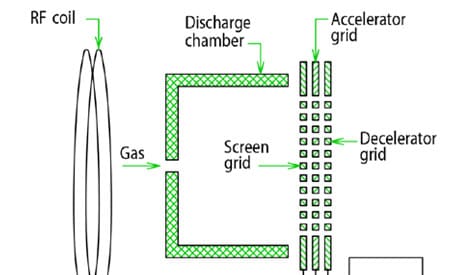
美國 KRi RFICP 220 三層柵網射頻離子源適用於 8寸金屬刻蝕機
三層柵網設計, 覆蓋面積更大, 精密控制離子束流的能量, 方向

美國 KRi 射頻離子源 RFICP 220 精密光學鍍膜解決方案
為精密光學鍍膜提供解決方案, 適用於濺射鍍, 蒸鍍, 膜層均勻且牢固
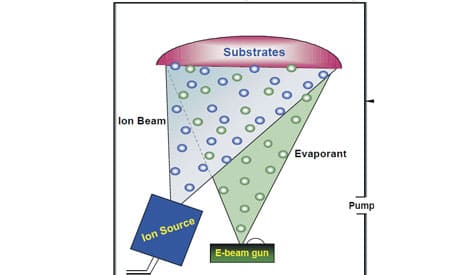
美國 KRi 三層柵網射頻離子源 RFICP 220 精密光學鍍膜應用
鍍金屬反射膜, 大型望遠鏡--3.2米量級主鏡鍍膜應用的真空鍍膜系統,用於改善金屬膜層附著力, 降低氧化物吸收和提高環境穩定性

KRi 射頻離子源 RFICP 220 8英寸 IBE 離子束刻蝕
RFICP 380, RFICP 220 成功應用於 12英寸和 8英寸 IBE 離子束蝕刻機, 實現 300mm 和 200 mm 矽片蝕刻

SRG 磁懸浮轉子真空計替代離子規適用於腐蝕和沉積環境
SRG 高精度磁懸浮轉子真空計, 耐腐蝕, 無燈絲設計, 沒有內在的污染源, 不會造成二次電離污染沉積. 完全替代離子規, 提供可靠的, 長期穩定的壓力測試, 更適合高污染的嚴苛工藝環境.

ph-instruments SRG 磁懸浮轉子真空計可替代 MKS, INFICON 離子規
可以替代離子規 MKS 903 AP,MKS GP 390,MKS GP 355,MKS GP 354, Inficon HPG400,Inficon MPG400 等型號

SRG 磁懸浮轉子真空計應用優勢
耐腐蝕和沉積, 無燈絲設計, 替代傳統的離子規(冷陰極離子規或熱陰極離子規)

SRG 磁懸浮轉子真空計應用優勢
耐腐蝕和沉積, 無燈絲設計, 替代傳統的離子規(冷陰極離子規或熱陰極離子規)

SRG 磁懸浮轉子規原理和特點(耐腐蝕,高精度,長期穩定)
SRG 旋轉轉子是一種高精度且穩定的真空測量技術, 核心感測元件是一個小型磁懸浮的鋼球, 透過管件連接到真空系統內

SRG 磁懸浮轉子規原理和特點(耐腐蝕,高精度,長期穩定)
SRG 旋轉轉子是一種高精度且穩定的真空測量技術, 核心感測元件是一個小型磁懸浮的鋼球, 透過管件連接到真空系統內

ph-instruments Dositorr SRG 磁懸浮轉子真空計離子注入應用
SRG 磁懸浮轉子真空計, 耐腐蝕, 無污染, 對沉積不敏感. 可替代離子注入工藝中的離子規, 解決常規離子規經常失效, 信號漂移等問題.

VIM-2 磁懸浮轉子真空計應用於真空絕緣監測
VIM-2 磁懸浮轉子真空計應用於真空絕緣監測, 測量和監控真空絕緣洩漏的壓力值, 長期穩定

ph-instruments SRG 磁懸浮轉子真空計可替代 MKS, INFICON 離子規
可以替代離子規 MKS 903 AP,MKS GP 390,MKS GP 355,MKS GP 354, Inficon HPG400,Inficon MPG400 等型號

ph-instruments SRG 磁懸浮轉子真空計可替代 MKS, INFICON 離子規
可以替代離子規 MKS 903 AP,MKS GP 390,MKS GP 355,MKS GP 354, Inficon HPG400,Inficon MPG400 等型號

SRG 磁懸浮轉子規原理和特點(耐腐蝕,高精度,長期穩定)
SRG 旋轉轉子是一種高精度且穩定的真空測量技術, 核心感測元件是一個小型磁懸浮的鋼球, 透過管件連接到真空系統內

SRG 磁懸浮轉子真空計應用優勢
耐腐蝕和沉積, 無燈絲設計, 替代傳統的離子規(冷陰極離子規或熱陰極離子規)

SRG 磁懸浮旋轉轉子真空計在眼科塗層 Opthalmic Coating 中的應用優勢
SRG 磁懸浮旋轉轉子真空計在鍍膜行業(如光學鍍膜, 硬質鍍膜)中, 其穩定的真空測量可確保膜層厚度均勻性, 減少批次間差異, 提升鍍膜產品光學性能與耐用性.

SRG 磁懸浮旋轉轉子真空計在眼科塗層 Opthalmic Coating 中的應用優勢
SRG 磁懸浮旋轉轉子真空計在鍍膜行業(如光學鍍膜, 硬質鍍膜)中, 其穩定的真空測量可確保膜層厚度均勻性, 減少批次間差異, 提升鍍膜產品光學性能與耐用性.

SRG 磁懸浮旋轉轉子真空計在眼科塗層 Opthalmic Coating 中的應用優勢
SRG 磁懸浮旋轉轉子真空計在鍍膜行業(如光學鍍膜, 硬質鍍膜)中, 其穩定的真空測量可確保膜層厚度均勻性, 減少批次間差異, 提升鍍膜產品光學性能與耐用性.

SRG 磁懸浮旋轉轉子真空計在眼科塗層 Opthalmic Coating 中的應用優勢
SRG 磁懸浮旋轉轉子真空計在鍍膜行業(如光學鍍膜, 硬質鍍膜)中, 其穩定的真空測量可確保膜層厚度均勻性, 減少批次間差異, 提升鍍膜產品光學性能與耐用性.

SRG 磁懸浮旋轉轉子真空計在光伏行業 Solar Collectors 中的應用優勢
SRG 磁懸浮旋轉轉子真空計可以在玻璃管內工作, 因此可以將帶有球的玻璃管焊接到玻璃真空室, 在製造過程中測量真空度.可用於光伏行業的維護, 製造和測試, 且方便拆卸

SRG 磁懸浮旋轉轉子真空計在光伏行業 Solar Collectors 中的應用優勢
SRG 磁懸浮旋轉轉子真空計可以在玻璃管內工作, 因此可以將帶有球的玻璃管焊接到玻璃真空室, 在製造過程中測量真空度.可用於光伏行業的維護, 製造和測試, 且方便拆卸

SRG 磁懸浮旋轉轉子真空計在光伏行業 Solar Collectors 中的應用優勢
SRG 磁懸浮旋轉轉子真空計可以在玻璃管內工作, 因此可以將帶有球的玻璃管焊接到玻璃真空室, 在製造過程中測量真空度.可用於光伏行業的維護, 製造和測試, 且方便拆卸

SRG 磁懸浮旋轉轉子真空計在光伏行業 Solar Collectors 中的應用優勢
SRG 磁懸浮旋轉轉子真空計可以在玻璃管內工作, 因此可以將帶有球的玻璃管焊接到玻璃真空室, 在製造過程中測量真空度.可用於光伏行業的維護, 製造和測試, 且方便拆卸

SRG 磁懸浮轉子真空計替代離子規適用於腐蝕和沉積環境
SRG 高精度磁懸浮轉子真空計, 耐腐蝕, 無燈絲設計, 沒有內在的污染源, 不會造成二次電離污染沉積. 完全替代離子規, 提供可靠的, 長期穩定的壓力測試, 更適合高污染的嚴苛工藝環境.

SRG 磁懸浮轉子真空計替代離子規適用於腐蝕和沉積環境
SRG 高精度磁懸浮轉子真空計, 耐腐蝕, 無燈絲設計, 沒有內在的污染源, 不會造成二次電離污染沉積. 完全替代離子規, 提供可靠的, 長期穩定的壓力測試, 更適合高污染的嚴苛工藝環境.

SRG 磁懸浮轉子真空計替代離子規適用於腐蝕和沉積環境
SRG 高精度磁懸浮轉子真空計, 耐腐蝕, 無燈絲設計, 沒有內在的污染源, 不會造成二次電離污染沉積. 完全替代離子規, 提供可靠的, 長期穩定的壓力測試, 更適合高污染的嚴苛工藝環境.

SRG 旋轉轉子真空規與離子規對比
SRG 旋轉轉子真空計精度高, 長期穩定, 不影響以任何方式測量的壓力信號(無溫度輸入 / 電離 / 採集 / 漂移等), 適用於半導體, 低溫真空絕熱, 高精度真空計校準系統.

SRG 旋轉轉子真空規與離子規對比
SRG 旋轉轉子真空計精度高, 長期穩定, 不影響以任何方式測量的壓力信號(無溫度輸入 / 電離 / 採集 / 漂移等), 適用於半導體, 低溫真空絕熱, 高精度真空計校準系統.

SRG 旋轉轉子真空規與離子規對比
SRG 旋轉轉子真空計精度高, 長期穩定, 不影響以任何方式測量的壓力信號(無溫度輸入 / 電離 / 採集 / 漂移等), 適用於半導體, 低溫真空絕熱, 高精度真空計校準系統.

上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 700 应用于离子束刻蚀机
涡轮分子泵 HiPace 700 应用于离子束刻蚀机 IBE, 45分钟内真空度达到 1X10-5 hPa, 24小时内的极限真空 8X10-7 hPa.
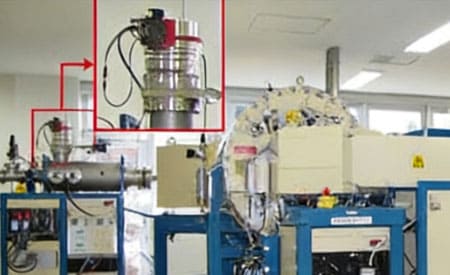
上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 700 应用于加速器质谱系统
7套涡轮分子泵 HiPace 700 应用于加速器质谱系统

ph-instruments Dositorr SRG 磁懸浮轉子真空計離子注入應用
SRG 磁懸浮轉子真空計, 耐腐蝕, 無污染, 對沉積不敏感. 可替代離子注入工藝中的離子規, 解決常規離子規經常失效, 信號漂移等問題.

ph-instruments Dositorr SRG 磁懸浮轉子真空計離子注入應用
SRG 磁懸浮轉子真空計, 耐腐蝕, 無污染, 對沉積不敏感. 可替代離子注入工藝中的離子規, 解決常規離子規經常失效, 信號漂移等問題.

SRG 磁懸浮轉子真空計應用於顯示面板腔體測量
磁懸浮轉子真空計具有長期的堅固性, 高度準確和穩定的壓力讀數, 耐腐蝕和沉積, 即使在腐蝕工藝中, 其他儀錶可能會漂移和失效, SRG 磁懸浮轉子真空計無影響.

SRG 磁懸浮轉子真空計應用於顯示面板腔體測量
磁懸浮轉子真空計具有長期的堅固性, 高度準確和穩定的壓力讀數, 耐腐蝕和沉積, 即使在腐蝕工藝中, 其他儀錶可能會漂移和失效, SRG 磁懸浮轉子真空計無影響.

SRG 磁懸浮轉子真空計應用於顯示面板腔體測量
磁懸浮轉子真空計具有長期的堅固性, 高度準確和穩定的壓力讀數, 耐腐蝕和沉積, 即使在腐蝕工藝中, 其他儀錶可能會漂移和失效, SRG 磁懸浮轉子真空計無影響.
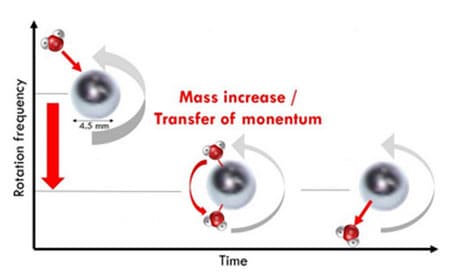
SRG 旋轉轉子真空計測量原理
SRG 旋轉轉子真空計測量原理,穩定測量優勢,固有的抗污染性和堅固設計,高精度和長期穩定性
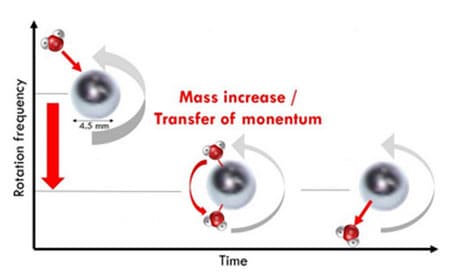
SRG 旋轉轉子真空計測量原理
SRG 旋轉轉子真空計測量原理,穩定測量優勢,固有的抗污染性和堅固設計,高精度和長期穩定性
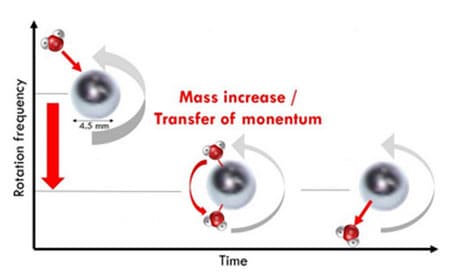
SRG 旋轉轉子真空計測量原理
SRG 旋轉轉子真空計測量原理,穩定測量優勢,固有的抗污染性和堅固設計,高精度和長期穩定性
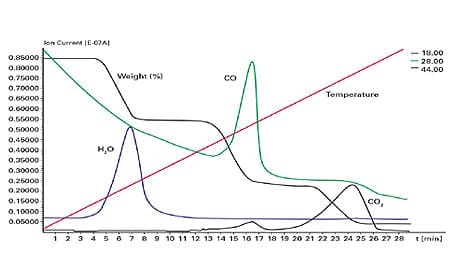
Pfeiffer 普發線上質譜分析儀 Omnistar GSD 350 應用於煤轉化過程催化
對煤轉化過程相關的催化材料和能源環境新材料的分析檢測提供化學和物理特性資訊

Pfeiffer 普發氣體質譜儀 GSD 350 線上即時分析
從“靜態, 離線”的研究模式轉向“動態, 原位”的觀察方式, 能夠捕捉反應過程中的暫態中間產物, 識別關鍵反應路徑

Pfeiffer 普發質譜分析儀 ThermoStar GSD 350 分析聚氯乙烯 PVC 燃燒產物
ThermoStar GSD 350 與熱天平 TGA 聯用, 能夠快速地分析熱重測試過程中逸出氣體產物

四極杆質譜儀 PrismaPro 真空釺焊過程中的殘餘氣體分析
真空爐監測分析釺焊, 燒結過程中的氣體變化. 可定量定性評估真空系統中的殘餘氣體成分

Pfeiffer 普發殘餘氣體分析儀 Hicube RGA 應用于環境水分析
採用膜進樣方式, 測試樣本水中氮氣, 氬氣比等, 滿足試驗要求

Pfeiffer 四極杆質譜儀搭配吸附儀進行化學催化廢氣分析
在化學實驗中對催化裂化過程中產生的廢氣進行測試, 確認是否有有害氣體存在.

Pfeiffer 四極杆質譜儀搭配吸附儀進行化學催化廢氣分析
在化學實驗中對催化裂化過程中產生的廢氣進行測試, 確認是否有有害氣體存在.

Pfeiffer 普发干式氦质谱检漏仪 ASM 340D 医疗控制阀门检漏
ASM 340D 医疗控制阀门检漏, 清洁无油, 高灵敏度, 快速准确, 非侵入性测试

Pfeiffer 普发干式氦质谱检漏仪 ASM 340D 植入式医疗器械检漏
ASM 340D 植入式医疗器械检漏, 为医疗行业的微创介入, 人体植入产品的密封性检漏测试提供解决方案.

Pfeiffer 普发氦质谱检漏仪 ASM 340D 密封继电器检漏
ASM 340D 航天相关的电子元器件泄漏检测, 微型密封高可靠极化继电器要求漏率小于 1×10-9 Pa m3/s.

Pfeiffer 普发氦质谱检漏仪 ASM 340 光学镀膜机检漏
ASM 340 光学镀膜机检漏, 真空模式下, 漏率要求达到 1X10-7 mbar l/s, 保证光学镀膜机在生产过程中的密封性.

Pfeiffer 普发氦质谱检漏仪 ASM 340 操作说明
ASM 340 简短操作说明, 适用机型 ASM 340 WET , ASM 340 DRY

KRi 霍爾離子源 eH 400 不規則電子晶片蒸鍍前清洗
霍爾離子源 eH 400 應用於蒸發鍍膜機, 不規則電子晶片蒸鍍前清洗, 經過清洗後的晶片鍍膜, 膜層厚度均勻性及附著牢固度都明顯提高.

KRi 霍爾離子源 eH 400 HC 應用於 IBE 離子束刻蝕機
霍爾離子源 eH 400 HC 實現 2英寸矽晶片蝕刻,對於 Fe, Se, Te ,PCCO 及多項材料刻蝕工藝

KRi 霍爾離子源 EH 3000 IBAD 輔助鍍膜
大尺寸霍爾離子源 EH 3000 應用於直徑 2.2m 蒸鍍機, 用於蒸鍍 1.5m 天文望遠鏡鏡片
美國 KRi 霍爾離子源 EH 3000 應用於蒸鍍直徑 2.2m 天文望遠鏡
霍爾離子源 EH 3000 應用於蒸鍍直徑 2.2m 天文望遠鏡, 鍍全反射膜, 高均勻性及高緻密性的膜層可以保障光源有效反射, 盡可能減少吸收

IBE 離子束刻蝕機物理量感測器 MEMS 刻蝕應用
離子束刻蝕機 IBE 可以很好的解決感測器 MEMS 的刻蝕難題, 射頻角度可以任意調整, 蝕刻可以根據需要做垂直, 斜面等等加工形狀, 刻蝕那些很難刻蝕的硬質或惰性材料.

IBE 離子束刻蝕機物理量感測器 MEMS 刻蝕應用
離子束刻蝕機 IBE 可以很好的解決感測器 MEMS 的刻蝕難題, 射頻角度可以任意調整, 蝕刻可以根據需要做垂直, 斜面等等加工形狀, 刻蝕那些很難刻蝕的硬質或惰性材料.

IBE 離子束刻蝕機物理量感測器 MEMS 刻蝕應用
離子束刻蝕機 IBE 可以很好的解決感測器 MEMS 的刻蝕難題, 射頻角度可以任意調整, 蝕刻可以根據需要做垂直, 斜面等等加工形狀, 刻蝕那些很難刻蝕的硬質或惰性材料.
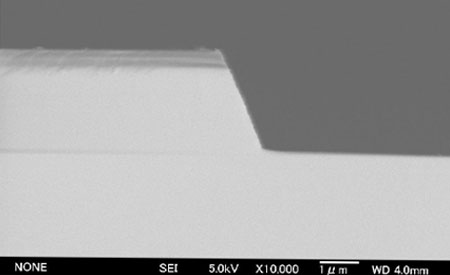
鈮酸鋰 LiNbO3 薄膜 IBE 離子束刻蝕
因 LiNbO3 惰性特性, 使用 ICP 或 RIE 工藝無法完成刻蝕, 伯東 IBE 離子束刻蝕機為鈮酸鋰 LiNbO3 薄膜刻蝕提供解決方案
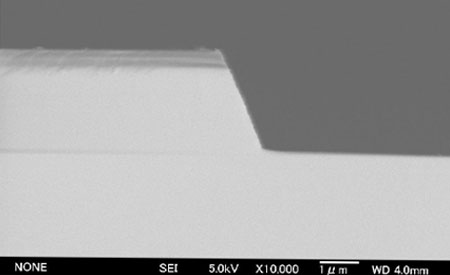
鈮酸鋰 LiNbO3 薄膜 IBE 離子束刻蝕
因 LiNbO3 惰性特性, 使用 ICP 或 RIE 工藝無法完成刻蝕, 伯東 IBE 離子束刻蝕機為鈮酸鋰 LiNbO3 薄膜刻蝕提供解決方案
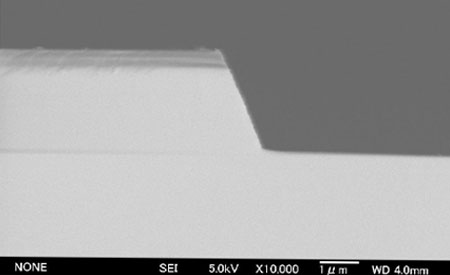
鈮酸鋰 LiNbO3 薄膜 IBE 離子束刻蝕
因 LiNbO3 惰性特性, 使用 ICP 或 RIE 工藝無法完成刻蝕, 伯東 IBE 離子束刻蝕機為鈮酸鋰 LiNbO3 薄膜刻蝕提供解決方案

IBE 離子束刻蝕機刻蝕應用
伯東提供 4-8寸 IBE 離子束刻蝕機, 可以實現 ICP 或 RIE 無法進行的刻蝕, 幾乎滿足所有材料的刻蝕

IBE 離子束刻蝕機刻蝕應用
伯東提供 4-8寸 IBE 離子束刻蝕機, 可以實現 ICP 或 RIE 無法進行的刻蝕, 幾乎滿足所有材料的刻蝕

IBE 離子束刻蝕機刻蝕應用
伯東提供 4-8寸 IBE 離子束刻蝕機, 可以實現 ICP 或 RIE 無法進行的刻蝕, 幾乎滿足所有材料的刻蝕

IBE 離子束刻蝕機刻蝕材料和速率
伯東 IBE 離子束刻蝕機可用於反應離子刻蝕 RIE 不能很好刻蝕的材料.是一種幹法物理納米級別的刻蝕, 刻蝕均勻性 ≤±5%(部分材料 ±3%).

IBE 離子束刻蝕機刻蝕材料和速率
伯東 IBE 離子束刻蝕機可用於反應離子刻蝕 RIE 不能很好刻蝕的材料.是一種幹法物理納米級別的刻蝕, 刻蝕均勻性 ≤±5%(部分材料 ±3%).

IBE 離子束刻蝕機刻蝕材料和速率
伯東 IBE 離子束刻蝕機可用於反應離子刻蝕 RIE 不能很好刻蝕的材料.是一種幹法物理納米級別的刻蝕, 刻蝕均勻性 ≤±5%(部分材料 ±3%).

IBE 離子束刻蝕設備 MRAM 磁性記憶體幹法刻蝕應用
刻蝕不易刻蝕的金屬或合成堆疊膜層 Ta, Ru, Pt … 及介質層 SiO2, SiNx …

IBE 離子束刻蝕設備 MRAM 磁性記憶體幹法刻蝕應用
刻蝕不易刻蝕的金屬或合成堆疊膜層 Ta, Ru, Pt … 及介質層 SiO2, SiNx …

IBE 離子束刻蝕設備 MRAM 磁性記憶體幹法刻蝕應用
刻蝕不易刻蝕的金屬或合成堆疊膜層 Ta, Ru, Pt … 及介質層 SiO2, SiNx …

IBE 離子束幹法刻蝕機在精密光柵加工中的應用優勢
伯東 IBE 離子束刻蝕機適用于閃耀羅蘭光柵, AR 眼鏡斜光柵, GaN光柵, 薄膜鈮酸鋰(LN)光柵耦合器製備

IBE 離子束幹法刻蝕機在精密光柵加工中的應用優勢
伯東 IBE 離子束刻蝕機適用于閃耀羅蘭光柵, AR 眼鏡斜光柵, GaN光柵, 薄膜鈮酸鋰(LN)光柵耦合器製備

IBE 離子束幹法刻蝕機在精密光柵加工中的應用優勢
伯東 IBE 離子束刻蝕機適用于閃耀羅蘭光柵, AR 眼鏡斜光柵, GaN光柵, 薄膜鈮酸鋰(LN)光柵耦合器製備

IBE 離子束刻蝕機工作原理與性能特點
IBE (Ion Beam Etching) 離子束刻蝕, 通常使用 Ar 氣體作為蝕刻氣體, 將與電子的衝擊產生的離子在 200~ 1000ev 的範圍內加速, 利用離子的物理動能

IBE 離子束刻蝕機工作原理與性能特點
IBE (Ion Beam Etching) 離子束刻蝕, 通常使用 Ar 氣體作為蝕刻氣體, 將與電子的衝擊產生的離子在 200~ 1000ev 的範圍內加速, 利用離子的物理動能

IBE 離子束刻蝕機工作原理與性能特點
IBE (Ion Beam Etching) 離子束刻蝕, 通常使用 Ar 氣體作為蝕刻氣體, 將與電子的衝擊產生的離子在 200~ 1000ev 的範圍內加速, 利用離子的物理動能
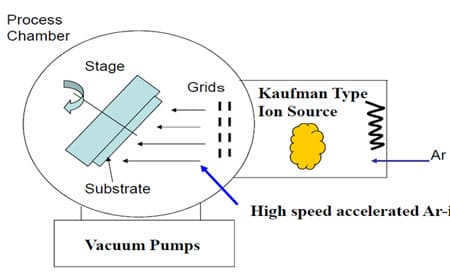
IBE 離子束刻蝕機應用優勢
伯東 IBE 離子束刻蝕機刻蝕最大 8寸的幾乎任何固體材料, 包括金屬, 合金, 氧化物, 化合物, 混合材料, 半導體, 絕緣體等
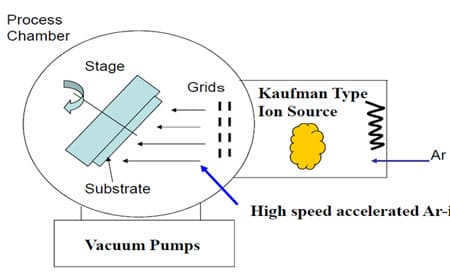
IBE 離子束刻蝕機應用優勢
伯東 IBE 離子束刻蝕機刻蝕最大 8寸的幾乎任何固體材料, 包括金屬, 合金, 氧化物, 化合物, 混合材料, 半導體, 絕緣體等
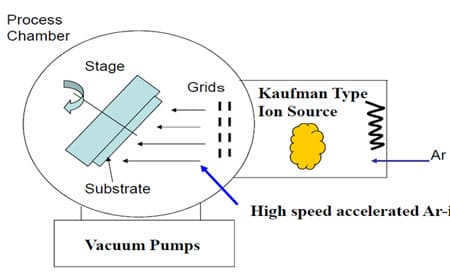
IBE 離子束刻蝕機應用優勢
伯東 IBE 離子束刻蝕機刻蝕最大 8寸的幾乎任何固體材料, 包括金屬, 合金, 氧化物, 化合物, 混合材料, 半導體, 絕緣體等

上海伯东 Pfeiffer 普发分子泵 HiPace 80 应用于 PLD 脉冲激光沉积设备
HiPace 80 应用于 PLD 脉冲激光沉积设备.从而实现该系统制备金属, 半导体, 氧化物, 氮化物, 碳化物, 硼化物, 硅化物, 硫化物及氟化物等各种物质薄膜和制备一些难以合成的材料膜, 如金刚石, 立方氮化物膜等.

上海伯东 Pfeiffer 普发分子泵 HiPace 80 应用于 PLD 脉冲激光沉积设备
HiPace 80 应用于 PLD 脉冲激光沉积设备.从而实现该系统制备金属, 半导体, 氧化物, 氮化物, 碳化物, 硼化物, 硅化物, 硫化物及氟化物等各种物质薄膜和制备一些难以合成的材料膜, 如金刚石, 立方氮化物膜等.

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空閥門應用于亞洲最大的粒子加速器系統
應用于中國研製的亞洲粒子加速器系統 100MV,HVA 帶孔真空插板閥, 可根據客戶需求進行定制

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 真空插板閥(真空閥門)用於鐳射真空系統
HVA 真空插板閥(真空閥門)用於鐳射真空系統

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 矩形閥 88200 系列 Load-lock 典型應用
應用於晶矽料生產設備中的 Load-lock 工位元, 美國 HVA 矩形閥 88200 系列, 具有獨特的密封系統, 可避免粉塵顆粒污染, 有效減少了維護次數

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 真空閘閥 11000 系列應用於 OLED 鍍膜機
為了節省抽空時間和防止基片的污染,會選擇在 LOADLOCK 與主腔間進行快速傳樣,由於兩腔室工作的真空度要求不同, 會在腔室之間增加 HVA高真空閘閥來隔離系統

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 高真空閘閥 11000 系列 應用於 E-Beam 鍍膜機
E-Beam 電子束蒸發鍍膜機用於在半導體, 光學, 超導材料等行業的研究與生產, 比如基片蒸發沉積金屬, 導電薄膜, 半導體薄膜, 鐵電薄膜, 光學薄膜和介質材料.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

HVA 真空閘閥在氣體管路系統應用
HVA 閘閥閥體和部件均是在真空爐中一體釺焊完成, 消除了虛漏的可能, 廣泛用在氣體輸送環節 (氣體管路系統) , 起到真空隔離密封作用.

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

伯東美國 HVA 真空插板閥應用於半導體管道中
美國 HVA 6寸, 8寸 真空插板閥已廣泛應用於半導體氣體管路中,滿足高真空 1E10-9 mabr 和超高真空 1E10-10 mbar 應用

InTest DCP-102 接觸式高低溫測試機高功率晶片測試
冷卻能力更強 -55C@55W, 適用于高功率晶片測試, MOSFET, IGBT, 積體電路 IC, 存儲晶片Memory等

ASM 340 氦质谱检漏仪 CT X射线管和管组件检漏
密封性泄露测试. 主要是对 X 射线管和管组件中的电路板和铝铸件进行检漏, 检漏仪真空模式下, 最小漏率可以达到 5E-13 Pa m3/s.

ASM 340 氦质谱检漏仪 CT X射线管和管组件检漏
密封性泄露测试. 主要是对 X 射线管和管组件中的电路板和铝铸件进行检漏, 检漏仪真空模式下, 最小漏率可以达到 5E-13 Pa m3/s.

ASM 340 氦质谱检漏仪 CT X射线管和管组件检漏
密封性泄露测试. 主要是对 X 射线管和管组件中的电路板和铝铸件进行检漏, 检漏仪真空模式下, 最小漏率可以达到 5E-13 Pa m3/s.

ASM 340 氦质谱检漏仪 CT X射线管和管组件检漏
密封性泄露测试. 主要是对 X 射线管和管组件中的电路板和铝铸件进行检漏, 检漏仪真空模式下, 最小漏率可以达到 5E-13 Pa m3/s.

美國 KRi 霍爾離子源 eH 400 輔助鍍膜 IBAD 應用
eH 400 應用於 e-beam 電子束蒸發系統, 實現 IBAD 輔助鍍膜, 通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性

美國 KRi 霍爾離子源 eH 400 輔助鍍膜 IBAD 應用
eH 400 應用於 e-beam 電子束蒸發系統, 實現 IBAD 輔助鍍膜, 通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性

美國 KRi 霍爾離子源 eH 400 輔助鍍膜 IBAD 應用
eH 400 應用於 e-beam 電子束蒸發系統, 實現 IBAD 輔助鍍膜, 通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性

美國 KRi 霍爾離子源 eH 400 輔助鍍膜 IBAD 應用
eH 400 應用於 e-beam 電子束蒸發系統, 實現 IBAD 輔助鍍膜, 通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性

美國 KRi 霍爾離子源 eH 400 輔助鍍膜 IBAD 應用
eH 400 應用於 e-beam 電子束蒸發系統, 實現 IBAD 輔助鍍膜, 通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性

KRI 霍爾離子源控制器成功替代 Veeco Commonwealth 控制器
不需更改任何鍍膜機電腦程式及相關設定即可直接運做

KRi 射频离子源 RFICP 325 LED-DBR 辅助镀膜
安装于 1650 mm 尺寸电子枪蒸镀镀膜机, 用于 LED-DBR 辅助镀膜, 精密光学镜头

InTest ATS-535 雙介面 IC 卡晶片高低溫衝擊測試
滿足客戶身份證用 NFC 晶片研發生產要求, 雙介面 IC卡晶片廣泛應用于金融 IC卡, 社保卡, 交通, ETC, 居民健康卡等應用場景.

InTest ATS-535 熱流儀半導體晶片高低溫測試
ATS-535 為半導體功率器件 ( MOSFET, IGBT, SIC, GaN,車規級晶片…), 功率模組, 功率積體電路, 智慧感測器等晶片研發提供高低溫測試解決方案.

InTest ATS-545 熱流儀光通信模組, 光纖收發器高低溫測試
ATS-545 升降溫速率更快; 可針對眾多元器件中的某一單個收發器, 將其隔離出來單獨進行高低溫衝擊, 而不影響周邊其它器件

InTest ATS-545 熱流儀用於12寸記憶體晶片 MRAM 研發測試
ATS-545 通過快速提供高低溫測試環境, 成功應用於 12寸記憶體晶片 MRAM 研發測試

InTest ATS-545 時鐘晶片高低溫衝擊測試
ATS-545-M 熱流儀與其測試設備搭配, 為分析時鐘晶片的各項特性, 提供快速可靠的溫度環境. 助力企業填補了國內時鐘領域的技術空白

InTest ATS-545 熱流儀車規級晶片高低溫衝擊測試
ATS-545 滿足汽車半導體行業更嚴格及更高效的測試要求, 可以對微控制單元 MCU, 感測器和記憶體 DRAM 等車載晶片進行快速高低溫衝擊測試, 極大節約了客戶研發成本

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest 熱流儀電源管理晶片高低溫衝擊測試
InTest熱流儀提供 -100°C 至 +225°C 快速溫度衝擊範圍, 滿足各類電源管理晶片的高低溫衝擊測試.

InTest ATS-545 熱流儀 PCB 板電子晶片高低溫測試
ATS-545 模擬 PCB 板在氣候環境下操作及儲存的適應性,已確保其在極端環境下也可正常工作

InTest ATS-545 熱流儀 PCB 板電子晶片高低溫測試
ATS-545 模擬 PCB 板在氣候環境下操作及儲存的適應性,已確保其在極端環境下也可正常工作
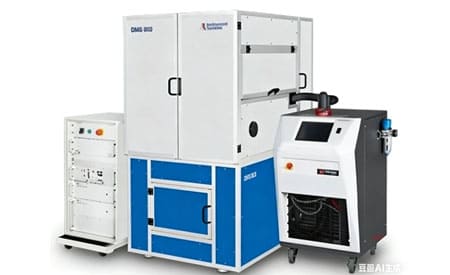
InTest ATS-710E 熱流儀 LED 液晶顯示幕高低溫衝擊測試
ATS-710E 與德國 AUTRONIC DMS 液晶顯示幕測量系統聯用進行 LED 環境溫度測試. 每個 DMS 系統都可以擴展一個適當的冷熱系統, 以進行 LED 光學顯示特性和一致性測試的溫度相關測量.
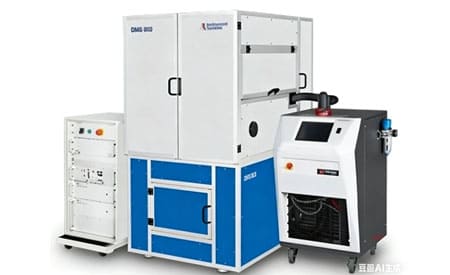
InTest ATS-710E 熱流儀 LED 液晶顯示幕高低溫衝擊測試
ATS-710E 與德國 AUTRONIC DMS 液晶顯示幕測量系統聯用進行 LED 環境溫度測試. 每個 DMS 系統都可以擴展一個適當的冷熱系統, 以進行 LED 光學顯示特性和一致性測試的溫度相關測量.
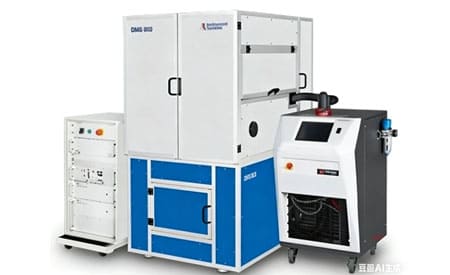
InTest ATS-710E 熱流儀 LED 液晶顯示幕高低溫衝擊測試
ATS-710E 與德國 AUTRONIC DMS 液晶顯示幕測量系統聯用進行 LED 環境溫度測試. 每個 DMS 系統都可以擴展一個適當的冷熱系統, 以進行 LED 光學顯示特性和一致性測試的溫度相關測量.
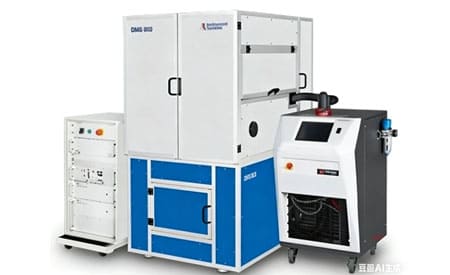
InTest ATS-710E 熱流儀 LED 液晶顯示幕高低溫衝擊測試
ATS-710E 與德國 AUTRONIC DMS 液晶顯示幕測量系統聯用進行 LED 環境溫度測試. 每個 DMS 系統都可以擴展一個適當的冷熱系統, 以進行 LED 光學顯示特性和一致性測試的溫度相關測量.
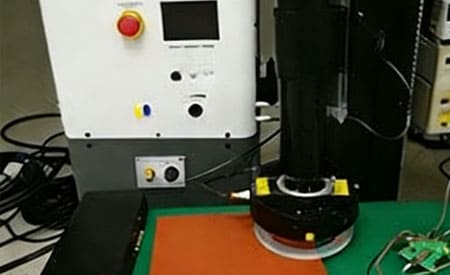
InTest ECO-560 高低溫測試機 400G 光模組溫度測試
ECO-560 高低溫測試機 400G 光模組溫度測試, 光模組目前廣泛應用於資料中心, 5G 移動通信和人工智慧行業.
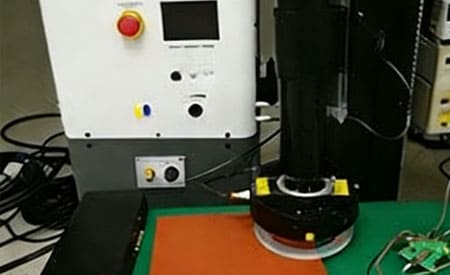
InTest ECO-560 高低溫測試機 400G 光模組溫度測試
ECO-560 高低溫測試機 400G 光模組溫度測試, 光模組目前廣泛應用於資料中心, 5G 移動通信和人工智慧行業.

InTest ATS-505 熱流儀積體電路 IC 卡高低溫測試
InTest ATS-505 熱流儀積體電路 IC 卡高低溫測試

InTest BT28 熱流儀光模組高低溫測試
InTest BT28 適用於對低溫要求不高的非高功率晶片或者器件測試, 例如光模組, 光通訊研發, 存儲晶片, MCU 晶片研發等

InTest ATS-545 熱流儀車載顯示器高低溫光學測量應用
ATS-545 適用于高低溫環境和光照環境下的車載顯示器光學測試系統, 實現各類車載顯示器在環境溫度和光照環境下的光學專案測試.

InTest ATS-710E 新能源汽車 IGBT 功率器件高低溫衝擊測試
在 -40℃ 至 175℃ 溫度下對 IGBT 進行快速溫度迴圈衝擊和功率迴圈測試. ATS-710E 高低溫衝擊熱流儀搭配測試機平臺 load board 為 IGBT 功率器件溫度測試提供解決方案.

InTest ATS-710E 新能源汽車 IGBT 功率器件高低溫衝擊測試
在 -40℃ 至 175℃ 溫度下對 IGBT 進行快速溫度迴圈衝擊和功率迴圈測試. ATS-710E 高低溫衝擊熱流儀搭配測試機平臺 load board 為 IGBT 功率器件溫度測試提供解決方案.

InTest ATS-710E 新能源汽車 IGBT 功率器件高低溫衝擊測試
在 -40℃ 至 175℃ 溫度下對 IGBT 進行快速溫度迴圈衝擊和功率迴圈測試. ATS-710E 高低溫衝擊熱流儀搭配測試機平臺 load board 為 IGBT 功率器件溫度測試提供解決方案.

InTest ATS-710E 新能源汽車 IGBT 功率器件高低溫衝擊測試
在 -40℃ 至 175℃ 溫度下對 IGBT 進行快速溫度迴圈衝擊和功率迴圈測試. ATS-710E 高低溫衝擊熱流儀搭配測試機平臺 load board 為 IGBT 功率器件溫度測試提供解決方案.

InTest ATS-750 車載功率晶片高低溫衝擊測試
ATS-750E 熱流儀又獲車載功率晶片高低溫測試訂單!為新能源汽車安全”保駕護航”!

KRi 霍爾離子源 eH 400F 典型應用濺鍍鍍膜預清潔工藝 Pre-clean
eH 400 成功應用於 6寸矽片電源管理積體電路晶片 PMIC 濺鍍鍍膜前預清潔工藝 Pre-clean.

KRi 考夫曼離子源應用於離子束拋光工藝
KRi 考夫曼離子源應用於光學鍍膜離子束拋光機及晶體矽片離子束拋光機

KRi 考夫曼離子源應用於離子束拋光工藝
KRi 考夫曼離子源應用於光學鍍膜離子束拋光機及晶體矽片離子束拋光機

KRi 考夫曼離子源應用於離子束拋光工藝
KRi 考夫曼離子源應用於光學鍍膜離子束拋光機及晶體矽片離子束拋光機

KRi 考夫曼離子源應用於離子束拋光工藝
KRi 考夫曼離子源應用於光學鍍膜離子束拋光機及晶體矽片離子束拋光機

KRi 考夫曼離子源應用於離子束拋光工藝
KRi 考夫曼離子源應用於光學鍍膜離子束拋光機及晶體矽片離子束拋光機

電子束鍍膜機加裝 KRi 霍爾離子源 EH 2000
eH 2000 加裝於電子束鍍膜機用於望遠鏡用金屬零部件 IBAD 輔助鍍膜
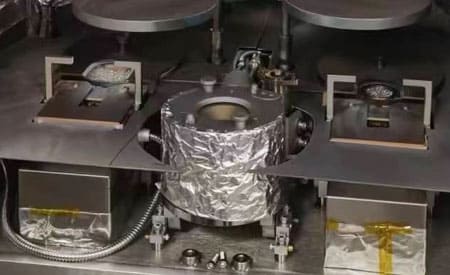
KRi 霍爾離子源 eH 2000 望遠鏡鏡片鍍膜應用
eH 2000 安装于高性能电子束光学镀膜机, 实现 300 mm 望远镜镜片镀膜.

KRi 考夫曼離子源 KDC 40 應用於 IBE 刻蝕 + E-beam 高真空雙腔系統
美國 KRi 考夫曼離子源 KDC 40 應用於 IBE 刻蝕 + E-beam 高真空雙腔系統

美國 KRi 考夫曼離子源 KDC 40 熱蒸鍍機應用
考夫曼離子源 KDC 40 進行鍍膜前基片預清潔 Pre-clean 和輔助鍍膜 IBAD 工藝, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等.

KRi 考夫曼離子源 KDC 40 應用於雙腔室高真空等離子 ALD 系統
KRi 考夫曼離子源 KDC 40 應用於雙腔室高真空等離子 ALD 系統

KRi 霍爾離子源 eH 1000 應用於科研級薄膜沉積設備
eH 1000 應用于高真空電子束蒸發設備 E-Beam, 4英寸的氧化膜沉積實驗.

KRi 霍爾離子源 eH 1000 應用於聚氨酯類的材料進行清洗前處理
霍爾離子源 eH 1000 安裝於磁控濺射設備對聚氨酯類的材料進行清洗前處理.

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 考夫曼離子源常見真空應用
離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝介紹

KRi 大尺寸射頻離子源 RFICP 380 應用于藍玻璃 AR工藝
光學鍍膜機加裝 KRi 大尺寸射頻離子源 RFICP 380, 在離子清洗, 輔助沉積時, 提高藍玻璃的薄膜 / 基層物的附著性和硬度, 減少吸收殘餘氣體的污染物和薄膜應力

美國 KRi 射頻離子源 RFICP 100 應用於國產離子束濺射鍍膜機 IBSD
RFICP 100 替換原有的國產離子源, 單次工藝時間可以達到數百小時, 維持高穩定離子束濺射工藝獲得高品質薄膜

KRi 考夫曼離子源 e-beam 電子束蒸發系統輔助鍍膜應用
通過加熱燈絲產生電子, KDC 系列離子源增強設計輸出低電流高能量寬束型離子束, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 實現輔助鍍膜 IBAD

KRi 考夫曼離子源 e-beam 電子束蒸發系統輔助鍍膜應用
通過加熱燈絲產生電子, KDC 系列離子源增強設計輸出低電流高能量寬束型離子束, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 實現輔助鍍膜 IBAD

KRi 考夫曼離子源 e-beam 電子束蒸發系統輔助鍍膜應用
通過加熱燈絲產生電子, KDC 系列離子源增強設計輸出低電流高能量寬束型離子束, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 實現輔助鍍膜 IBAD

KRi 考夫曼離子源 e-beam 電子束蒸發系統輔助鍍膜應用
通過加熱燈絲產生電子, KDC 系列離子源增強設計輸出低電流高能量寬束型離子束, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 實現輔助鍍膜 IBAD

KRi 考夫曼離子源 e-beam 電子束蒸發系統輔助鍍膜應用
通過加熱燈絲產生電子, KDC 系列離子源增強設計輸出低電流高能量寬束型離子束, 通過同時的或連續的離子轟擊表面使原子(分子)沉積在襯底上形成薄膜, 實現輔助鍍膜 IBAD
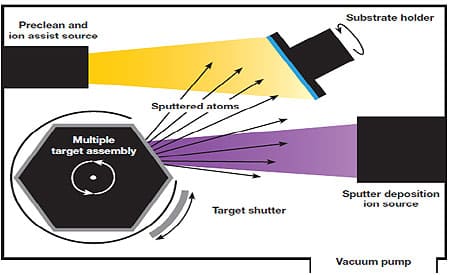
KRi 射頻離子源 IBSD 離子束濺射沉積應用
KRi 射頻離子源 IBSD 離子束濺射沉積應用
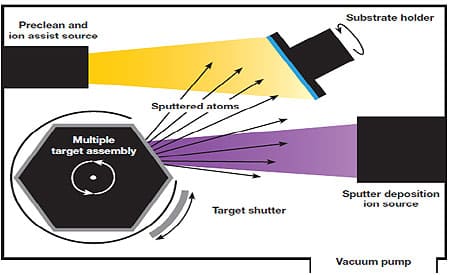
KRi 射頻離子源 IBSD 離子束濺射沉積應用
KRi 射頻離子源 IBSD 離子束濺射沉積應用
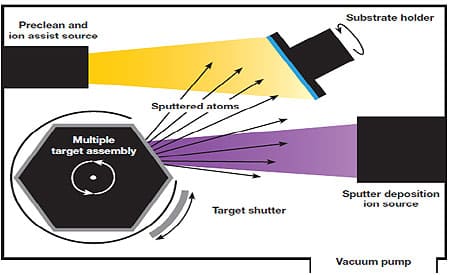
KRi 射頻離子源 IBSD 離子束濺射沉積應用
KRi 射頻離子源 IBSD 離子束濺射沉積應用
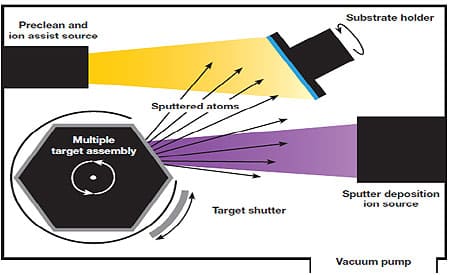
KRi 射頻離子源 IBSD 離子束濺射沉積應用
KRi 射頻離子源 IBSD 離子束濺射沉積應用
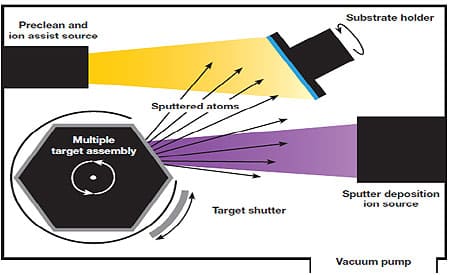
KRi 射頻離子源 IBSD 離子束濺射沉積應用
KRi 射頻離子源 IBSD 離子束濺射沉積應用

美國 KRi 考夫曼離子源 KDC 10 矽片刻蝕應用
KDC 10 離子源用於自主搭建離子束刻蝕機, 進行 1寸或2寸晶圓 (矽片) 刻蝕

KRi 考夫曼離子源 KDC 100 應用於 IBE 離子束刻蝕機
應用於刻蝕 2寸,4寸金屬和多層氧化物, 滿足客戶研發液晶功能材料及器件, 如光柵器件(透射式, 螺旋式和閃耀式光柵) 等要求.

KRi 考夫曼離子源 KDC 100 應用於 IBE 離子束刻蝕機
應用於刻蝕 2寸,4寸金屬和多層氧化物, 滿足客戶研發液晶功能材料及器件, 如光柵器件(透射式, 螺旋式和閃耀式光柵) 等要求.

KRi 考夫曼離子源 KDC 100 應用於 IBE 離子束刻蝕機
應用於刻蝕 2寸,4寸金屬和多層氧化物, 滿足客戶研發液晶功能材料及器件, 如光柵器件(透射式, 螺旋式和閃耀式光柵) 等要求.

KRi 考夫曼離子源 KDC 100 應用於 IBE 離子束刻蝕機
應用於刻蝕 2寸,4寸金屬和多層氧化物, 滿足客戶研發液晶功能材料及器件, 如光柵器件(透射式, 螺旋式和閃耀式光柵) 等要求.

KRi 考夫曼離子源 KDC 100 應用於 IBE 離子束刻蝕機
應用於刻蝕 2寸,4寸金屬和多層氧化物, 滿足客戶研發液晶功能材料及器件, 如光柵器件(透射式, 螺旋式和閃耀式光柵) 等要求.

KRi 考夫曼離子源 KDC 160 應用於矽片刻蝕清潔
KDC 160 應用於矽片刻蝕系統: 批量處理, 行星載台 4 x 10 片, 刻蝕均勻性 <±5%

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 考夫曼離子源表面預清潔 Pre-clean 應用
離子源預清潔 Pre-clean 的工藝, 對基材表面有機物清洗, 金屬氧化物的去除等, 提高沉積薄膜附著力, 純度, 應力, 工藝效率等

KRi 射頻離子源應用於 12英寸和8英寸金屬蝕刻機中
12英寸和 8英寸磁記憶體刻蝕機, 8英寸量產型金屬刻蝕機中, 實現 8英寸 IC 製造中的 Al, W 刻蝕工藝, 適用於 IC, 微電子,光電子, MEMS 等領域.

KRi 射頻離子源應用於 12英寸和8英寸金屬蝕刻機中
12英寸和 8英寸磁記憶體刻蝕機, 8英寸量產型金屬刻蝕機中, 實現 8英寸 IC 製造中的 Al, W 刻蝕工藝, 適用於 IC, 微電子,光電子, MEMS 等領域.

線上質譜分析儀 Omnistar 熱催化分析
Omnistar 對經過熱催化後的氣體 CH4, NO, CO2 等氣體進行分析. 熱催化主要涉及在較低溫度 (≤ 523 K) 的加氫反應, 生成 CH4, NO, CO2 等氣體. 熱催化是催化 CO2 轉化最常用的方法之一.

Pfeiffer 普發殘餘氣體分析儀 QMG 250 超高真空排氣台應用
QMG 250 用於分析真空環境下超高真空排氣台部件釋放的氣體成分和含量, 此超高真空排氣台主要用於製造電氣壓力開關, 排氣效率決定了成品的品質.

Pfeiffer 普發殘餘氣體分析儀 PrismaPro 應用於電化學反應研究電池反應過程
PrismaPro 殘餘氣體分析儀搭建分析系統, 檢測電池充放電過程中的逸出氣體如 H2, CO, CO2, N2 等, 用於研究鋰電池 (三元材料, 磷酸鐵鋰之類的) 反應過程, 解決電池使用過程中的鼓包, 衰減等問題, 從而開發動力性高比能量電池.

Pfeiffer 普發殘餘氣體分析儀 PrismaPro 應用於礦井瓦斯氣體檢測
PrismaPro 用於檢測研究礦井中的瓦斯氣體成分和含量.

Pfeiffer 普發線上質譜分析儀與熱重聯用
Pfeiffer 線上質譜分析儀與熱重分析儀 (TGA) 聯用, 能夠快速地分析熱重測試過程中逸出氣體產物

Pfeiffer 普發質譜分析儀與催化劑評價裝置聯用
Pfeiffer 質譜分析儀通過與催化劑評價裝置聯用, 可以實現直接檢測反應產物氣體. 考察不同壓力, 溫度等條件下的反應物變化, 完成諸如催化劑的機理研究

Pfeiffer 普發質譜分析儀與催化劑評價裝置聯用
Pfeiffer 質譜分析儀通過與催化劑評價裝置聯用, 可以實現直接檢測反應產物氣體. 考察不同壓力, 溫度等條件下的反應物變化, 完成諸如催化劑的機理研究

Pfeiffer 普發質譜分析儀與催化劑評價裝置聯用
Pfeiffer 質譜分析儀通過與催化劑評價裝置聯用, 可以實現直接檢測反應產物氣體. 考察不同壓力, 溫度等條件下的反應物變化, 完成諸如催化劑的機理研究
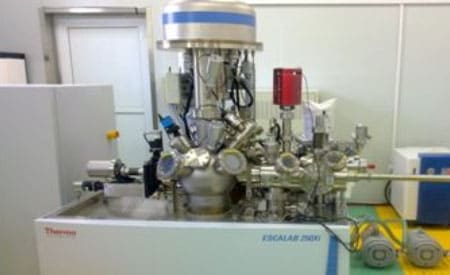
Pfeiffer 普發殘餘氣體分析儀 QMG 250 應用於角分辨光電子能譜儀 XPS
QMG 250 對 XPS 系統的分析室殘餘氣體進行定性和半定量分析, 並針對殘餘氣體進行除氣措施

Pfeiffer 普發殘餘氣體分析儀 QMG 250 應用于分子束外延 MBE
QMG 250 殘餘氣體分析儀應用于分子束外延 MBE, 對超高真空腔體進行檢漏, 及材料放氣組分及水汽進行分析, 確保超高真空及真空的穩定性
上海伯东氦质谱检漏仪 ASM 340D 数据中心液冷散热设备检漏
CPU (中央处理器) 和 GPU (图形处理器) 是 AI 系统中重要的两种计算核心, CPU 和 GPU 的温度是衡量计算机系统散热效率和稳定性的关键指标

殘餘氣體分析儀 Hicube RGA 應用於高溫真空爐, 實現品質保證和過程優化
Hicube RGA 殘餘氣體分析儀與高溫真空爐連接, 測試產品在不同溫度下揮發的產物變化, 進一步分析產品的耐用性以及使用形態.
上海伯东 ASM 310 氦质谱检漏仪 EUV 光刻机检漏
ASM 310 EUV 光刻机检漏, 光刻机真空度需要达到 1x10-11 pa 的超高真空, 需要对构成光刻机的真空相关部件进行检漏且要求清洁无油

上海伯东氦质谱检漏仪 ASM 310 电子束光刻机检漏
当真空度达到 15 hPa 时, 在腔体周围怀疑有漏的位置吹扫一定量的氦气, 同时启动便携式检漏仪 ASM 310 开始检漏

上海伯东便携式检漏仪 ASM 310 红外探测器杜瓦封装检漏
红外探测器需要在超低温下工作. 因此需要将红外探测器封装在杜瓦瓶中, 组装成杜瓦封装器件

上海伯东氦质谱检漏仪 ASM 390 激光器零件检漏
应用于航天领域的激光器零件检漏, 中空夹层设计, 仅在两端焊接密封, 真空模式下, 焊缝处漏率要求 < 10-9 Atm.cc/s.

上海伯东氦质谱检漏仪 ASM 390 减压器检漏
减压器主要用于半导体管路中气体减压, 调节气体压力, 减压器要求在真空模式下漏率小于 1X10-8 mbar l/S

上海伯东氦质谱检漏仪 ASM 390 半导体用配管配件检漏
定制不锈钢管, 配件和歧管广泛应用于半导体厂务端, 用于输送高压氧气, 氢气等. 客户从现场量测管路, 然后对不同管路的口径进行焊接, 产品漏率值需要达到 <1E-9mar l/s

上海伯东氦质谱检漏仪 ASM 390 罐式集装箱(压力容器)检漏
应用于运输腐蚀性液体的大型车或船用防腐罐箱(压力容器), 真空模式下, 漏率需要达到 -11 Pa m3/s

上海伯东氦质谱检漏仪 ASM 380 热交换器检漏
ASM 380 对体积 >1000L 的热交换器进行检漏, 热交换器内部管子细长, 流导小, 需要尽可能的快速测试并要求清洁无油

上海伯东 Pfeiffer 普发氦质谱检漏仪 ASM 392 调节阀气路管道检漏
ASM 392 调节阀中的气路管道检漏, 经过检漏后的调节阀广泛应用于电厂, 生物制药,化工等行业.

上海伯东 Pfeiffer 普发模块化检漏仪 ASI 35 应用于电子元器件检漏系统
ASI 35 用于电子元器件检漏. 真空模式下, 漏率 5x10-7 mbar l/s.

上海伯东 Pfeiffer 普发模块化检漏仪 ASI 35 汽车燃油箱检漏系统
模块化检漏仪应用于汽车燃油箱检漏系统
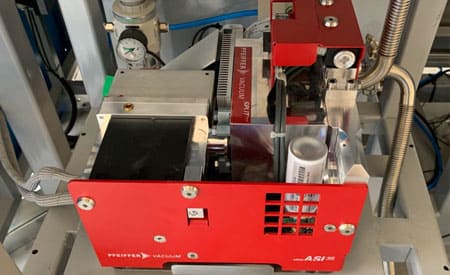
上海伯东 Pfeiffer 普发模块检漏仪 ASI 35 应用于氢能行业真空箱检漏系统
ASI 35 作为自动氦检漏系统的核心部件, 提供可靠, 可重复的泄露检测, 满足氢能行业真空箱检漏系统要求.
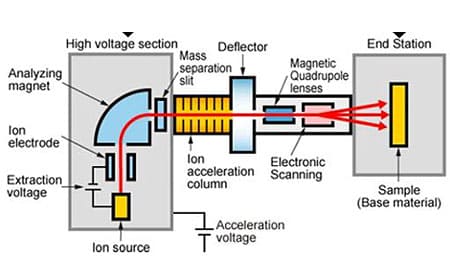
伯東 SRG 磁懸浮轉子真空計適用於半導體工藝中的精確真空監測
在半導體離子注入工藝中, SRG 磁懸浮轉子真空計零失誤, 零偏差, 精准測量
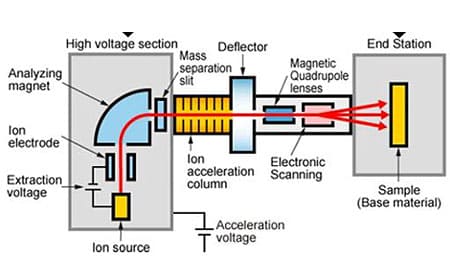
伯東 SRG 磁懸浮轉子真空計適用於半導體工藝中的精確真空監測
在半導體離子注入工藝中, SRG 磁懸浮轉子真空計零失誤, 零偏差, 精准測量

上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 1500 U 应用于镀膜生产线
涡轮分子泵 HiPace 1500 U 应用于玻璃触控模组的镀膜生产线

上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 700 应用于磁控溅射系统
分子泵 HiPace 700 磁控溅射系统, 用于光刻胶片上溅金属铬, 铜, 钛
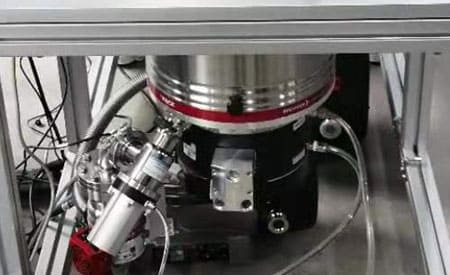
上海伯东 Pfeiffer 普发分子泵 HiPace 2300 应用于真空校准系统
非标成套真空设备厂商, 其生产的真空校准系统配置 涡轮分子泵 HiPace 2300

上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 2300 集成在 Hauzer 镀膜设备中
涡轮分子泵 HiPace 2300 集成在 Hauzer 镀膜设备中

上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 2300 应用于电子束蒸发镀膜
电子束蒸发镀膜系统配置涡轮分子泵 HiPace 2300, 用于生长半导体材料, 金属膜, Mn 氧化物膜.

上海伯东 Pfeiffer 普发双级旋片泵 Duo 3 应用于冻干机设备
双级旋片泵 Duo 3 应用于冻干机设备

上海伯东 Pfeiffer 普发双级旋片泵 Duo 3 应用于冻干机设备
双级旋片泵 Duo 3 应用于冻干机设备

上海伯东 Pfeiffer 普发双级旋片泵 Duo 3 应用于冻干机设备
双级旋片泵 Duo 3 应用于冻干机设备

上海伯东 Pfeiffer 普发双级旋片泵 Duo 3 应用于冻干机设备
双级旋片泵 Duo 3 应用于冻干机设备

上海伯东 Pfeiffer 普发双级旋片泵应用于检测仪器
双级旋片泵应用于检测仪器, 提供测定材料特性的真空解决方案

上海伯东 Pfeiffer 普发双级旋片泵应用于检测仪器
双级旋片泵应用于检测仪器, 提供测定材料特性的真空解决方案

上海伯东 Pfeiffer 普发双级旋片泵应用于检测仪器
双级旋片泵应用于检测仪器, 提供测定材料特性的真空解决方案

上海伯东 Pfeiffer 普发双级旋片泵应用于检测仪器
双级旋片泵应用于检测仪器, 提供测定材料特性的真空解决方案

上海伯东分析仪器中的真空系统(SplitFlow 分流分子泵应用)
SplitFlow 分流分子泵应用于各类分析仪器中

上海伯东分析仪器中的真空系统(SplitFlow 分流分子泵应用)
SplitFlow 分流分子泵应用于各类分析仪器中
上海伯东 Pfeiffer 干式真空泵 (多级罗茨泵) ACP 15 G 为气体水分仪提供洁净真空环境
ACP 15 G 为气体水分仪提供洁净真空环境

使用壓敏膠帶 GP-CLEANTAPE 清潔 Gel-Pak 膠面
使用 Gel-Pak 壓敏膠帶 GP-CLEANTAPE/075 或者 GP-CLEANTAPE/175 小心覆蓋在污染膠面表面
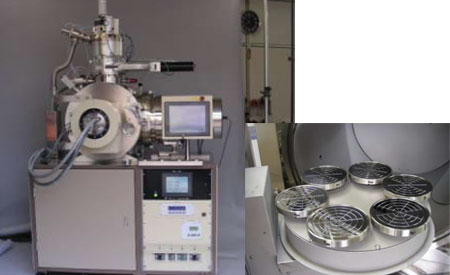
伯東離子束刻蝕機 20IBE-C 在 BAW/SAW 濾波器刻蝕中的應用
IBE 離子束刻蝕機 20IBE-C 成為 BAW/SAW 濾波器製造的關鍵工藝之一.
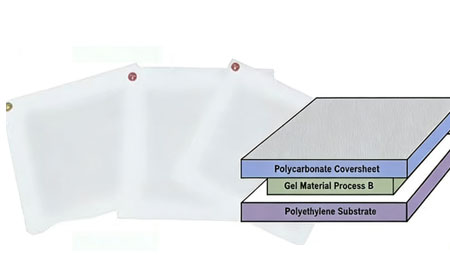
伯東美國 Gel-Pak DGL 膠膜在真空鍍膜行業的應用
DGL 膠膜提供粘性的表面, 可以在鍍膜過程中固定住器件, 比如玻璃, 石英, 光學器件等
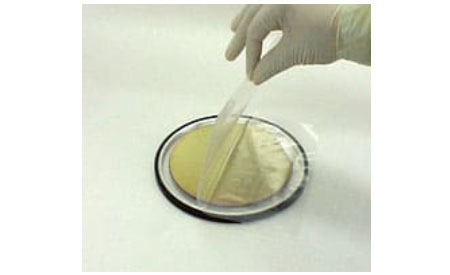
Gel-Pak DGL 膠膜在化合物半導體晶圓 Scribe &Break 中的應用
DGL 膠膜可以取代 Mylar 膜, 應用在裂片 Break 制程前

上海伯东 HiCube 80 Eco 普发涡轮分子泵组医疗导管抽真空
HiCube 80 Eco 涡轮分子泵组医疗导管抽真空,导管利用真空绝热的原理, 外管抽真空 <10-5 hPa 就可以防止或者减少冷或热传递到外层

上海伯东 Pfeiffer 普发分子泵组 HiCube 80 Eco 搭配低温阻抗测试仪
HiCube 80 Eco 普发分子泵组搭配低温阻抗测试仪,分析电子元器件在低温环境下电阻的变化

上海伯东 Pfeiffer 普发分子泵组 HiCube 80 Eco 应用于红外原位分析平台
分子泵组应用于红外原位分析平台

上海伯东 Pfeiffer 普发分子泵组 HiCube 80 应用于低温真空探针台
HiCube 80 分子泵组应用于低温真空探针台, 即插即用, 提供清洁, 低振动, 稳定的高真空环境
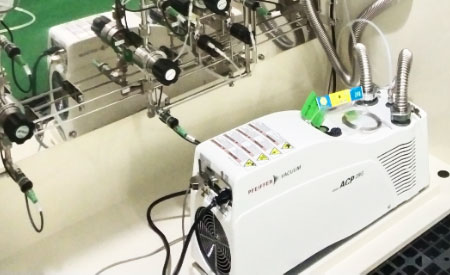
伯東 Pfeiffer 普發多級羅茨泵 ACP 28 G 特氣櫃應用
ACP 28 G 以無油潔淨, 防腐耐用, 穩定可靠, 緊湊低耗, 長週期免維護, 成為高危/高純特氣輸送系統的理想真空解決方案.

伯東 Hakuto Genius 線上質譜分析儀同位素測試
某科研單位採購 Hakuto Genius 線上質譜分析儀 1-200 amu, 主要用於測試同位素或催化分析
相关推荐
资料下载
-
上海伯东 Pfeiffer 普发双级旋片泵 DuoVane 3, 单相, 100 – 115/200 – 230 V, 50/60 Hz
-
上海伯东 Pfeiffer 普发双级旋片泵 DuoVane 12,三相电机
-
上海伯东 Pfeiffer 普发双级旋片泵 DuoVane 12 单相电机
-
Pfeiffer 普发涡轮分子泵 HiPace 80 Neo with TC 80, DN 63 ISO-K
-
上海伯东 Pfeiffer 普发干式真空泵 ACP 28 G, 单项电机, 110 – 230 V AC (±10 %), 50/60 Hz
-
上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 700 Plus with TC 400, DN 160 ISO-K
-
上海伯东 Pfeiffer 普发干式真空泵 ACP 120G, with inlet tube
-
上海伯东 Gel-Pak 集成真空台 / 拾取工具 GP-TrayVac-A
-
上海伯东 Pfeiffer 普发皮拉尼真空计 TPR 270, DN 16 ISO-KF, 80 °C
-
上海伯东 Pfeiffer 普发涡轮分子泵组 HiCube 80 Neo DN 63 ISO-KF, MVP 015-2
-
上海伯东 Pfeiffer 普发涡轮分子泵组 HiCube 80 Neo DN 40 ISO-KF, MVP 015-2
-
上海伯东 Pfeiffer 普发涡轮分子泵组 HiCube 80 Neo DN 63CF-F, MVP 015-2
-
上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 450 with TC 400, DN 160 CF-F, 24 V DC
-
上海伯东日本 NS 离子束刻蚀机 20 IBE-J
-
上海伯东日本 NS 离子束刻蚀机 20 IBE-C
-
上海伯东日本 NS 离子束刻蚀机 10 IBE
-
上海伯东美国 InTest ATS-505 桌面型高低温冲击热流仪
-
上海伯东 Pfeiffer 普发皮拉尼真空计 TPR 280 80 °C DN 16 ISO-KF
-
上海伯东 Pfeiffer 普发皮拉尼真空计 TPR 281 80 °C DN 16 ISO-KF
-
上海伯东 Pfeiffer 普发涡轮分子泵 HiPace 10 Neo with TC 80, DN 40
-
上海伯东 Pfeiffer 普发隔膜泵 MVP 015-4 DC Neo, 24 V DC, G 1/8"
-
上海伯东 Pfeiffer 普发数字型真空计 MPT 200 DN 25 ISO-KF, RS-485,EtherCAT
-
上海伯东 Pfeiffer 普发数字型真空计 HPT 200 DN 25 ISO-KF, RS-485, EtherCAT
-
Pfeiffer 普发冷阴极真空计 IKR 251 DN 40 ISO-KF
-
Pfeiffer 普发冷阴极真空计 IKR 251 DN 25 ISO-KF
-
Pfeiffer 普发冷阴极真空计 IKR 251 DN 40 CF-F
-
上海伯东 Pfeiffer 普发手持真空计 TPG 202 Neo
-
上海伯东 Pfeiffer 普发手持真空计 TPG 201
-
上海伯东 Pfeiffer 普发残余气体分析仪 PrismaPro
-
上海伯东 Pfeiffer 普发在线质谱分析仪 OmniStar® / ThermoStar®
-
上海伯东 Pfeiffer 普发氦质谱检漏仪 ASM 390
-
上海伯东 Pfeiffer 普发便携式氦质谱检漏仪 ASM 310
-
上海伯东 Pfeiffer 普发氦质谱检漏仪 ASM 340D
-
上海伯东 Pfeiffer 普发氦质谱检漏仪 ASM 340W
-
上海伯东美国 InTest 高低温冲击热流仪 ATS-545-T
-
上海伯东美国 InTest 高低温冲击热流仪 ATS-545-M
-
上海伯东 Pfeiffer 普发热阴极真空计 PBR 360 DN 40 CF-R
-
上海伯东 Pfeiffer 普发热阴极真空计 PBR 360 DN 40 ISO-KF
-
上海伯东 Pfeiffer 普发热阴极真空计 PBR 360 DN 25 ISO-KF
-
Pfeiffer 普发全量程真空计 RKR 361 DN25 ISO-KF
-
Pfeiffer 普发全量程真空计 RKR 251 DN 40 ISO-KF
-
Pfeiffer 普发全量程真空计 RKR 251 DN 40 CF-F
-
Pfeiffer 普发全量程真空计 PKR 251 DN 25 ISO-KF
-
上海伯东 Pfeiffer 普发真空角阀 AVC 025 SA
-
Pfeiffer 普发干式涡旋真空泵 HiScroll 46 三相电机,ATEX 标准
-
Pfeiffer 普发防爆型双级旋片泵 DUO 11 ATEX
-
考夫曼离子源
Copyright © HAKUTO ENTERPRISES (SHANGHAI) LTD. Allrights Reserved. Design by Maya

















