2026-01-27 更新
阅读数 : 108
2026-01-27 更新
阅读数 : 108
美國 KRi 射頻離子源 RFICP 220 增強光學基片反射及透射率
伯東美國 KRi 高能量射頻離子源 RFICP 220 應用於光學鍍膜機, 增強光學基片反射及透射率, 助力光學薄膜技術發展.
KRi 射頻離子源在光學鍍膜機中的作用
設備: 自主搭建光學鍍膜機, 光學薄膜強鐳射裝置組成部分之一
美國原裝進口高能射頻離子源: RFICP 220
作用: 通過玻璃鏡片表面清潔 Pre-clean 和輔助鍍膜 IBAD 工藝, 增強光學基片反射及透射率. 從而加強雷射光束, 對薄膜內部進行雜質和缺陷消除, 解決光學薄膜內部因存在雜質與缺陷導致的鐳射損傷問題
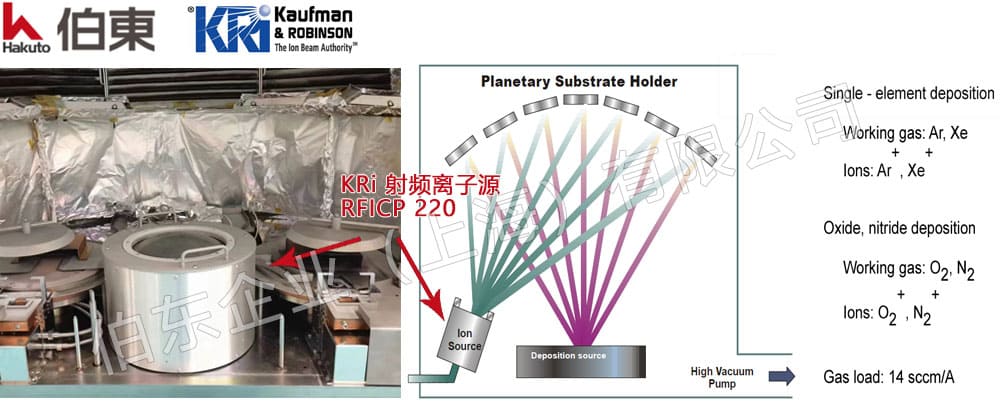
真空環境下, KRi 射頻離子源通過向生長的薄膜中添加能量來增強分子動力學, 以增加表面和原子 / 分子的流動性, 實現薄膜的緻密化或通過向生長薄膜中添加活性離子來增強薄膜化合物的化學轉化, 從而得到需要的材料. 同時 KRi 射頻離子源可以對工藝過程優化, 無需加熱襯底, 對溫度敏感材料進行低溫處理, 簡化反應沉積.
伯東美國 KRi 射頻離子源 RFICP 220 : 高能量射頻離子源, 適用於離子濺鍍, 離子沉積和離子蝕刻. 滿足 200 mm (8英寸) 晶圓應用. 射頻離子源 RFICP 220 可以很好的控制離子束沉積或濺射靶材, 實現更佳的薄膜特性. 標準配置下RFICP 220 離子能量範圍 100 至 1200ev, 離子電流可以超過 1000 mA.
|
陽極 |
電感耦合等離子體 |
|
最大陽極功率 |
>1kW |
|
最大離子束流 |
> 1000mA |
|
電壓範圍 |
100-1200V |
|
離子束動能 |
100-1200eV |
|
氣體 |
Ar, O2, N2, 其他 |
|
流量 |
5-50 sccm |
|
壓力 |
< 0.5mTorr |
|
離子光學, 自對準 |
OptiBeamTM |
|
離子束柵極 |
22cm Φ |
|
柵極材質 |
鉬 |
|
離子束流形狀 |
平行,聚焦,散射 |
|
中和器 |
LFN 2000 or RFN |
|
高度 |
30 cm |
|
直徑 |
41 cm |
|
鎖緊安裝法蘭 |
10”CF |
伯東美國 KRi 考夫曼離子源適用於各類真空設備, 實現離子清洗 PC, 離子刻蝕 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 和離子束拋光 IBF 等工藝. 在真空環境下, 通過使用美國 KRi 考夫曼離子源, 製造從微米到亞納米範圍的關鍵尺寸的結構, KRi 離子源具有原子級控制的材料和表面特徵.
1978 年 Dr. Kaufman 博士在美國創立 Kaufman & Robinson, Inc 公司, 研發生產考夫曼離子源, 霍爾離子源和射頻離子源. 美國考夫曼離子源歷經 40 年改良及發展已取得多項成果. 離子源廣泛用於離子清洗 PC, 離子蝕刻 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 領域, 伯東是美國KRi考夫曼離子源中國總代理.
.jpg)
伯東同時提供各類真空系統所需的渦輪分子泵, 真空規, 高真空插板閥等產品, 協助客戶生產研發高品質的真空系統.
若您需要進一步的瞭解 KRi 射頻離子源 詳細資訊或討論, 請參考以下聯絡方式:
上海伯東: 葉小姐 臺灣伯東: 王小姐
M: +86 1391-883-7267 ( 微信同號 ) M: +886-939-653-958
伯東版權所有, 翻拷必究!
上海伯东版权所有, 翻拷必究!